电子电路中MOS管讲解:定义、结构、分类及工作原理等
电子电路是由各种电子器件组成的,因此学习电子电路中,必须要熟悉各种电子器件性能,今天就给大家讲解MOS管,主要内容如下:
1.MOS管的定义
2.0 MOS管的结构
3.0 MOS管分类
4.MOS管工作原理
5.MOS管的工作参数
6.MOS管的基本特性
1.MOS管的定义
什么是MOS管?
MOS管的英文全称叫(Metal Oxide Field ),即金属氧化物半导体型场效应管,属于场效应管中的绝缘栅型。因此,MOS管有时被称为绝缘栅场效应管。在一般电子电路中,MOS管通常被用于放大电路或开关电路
2.0 MOS管的结构
在一块掺杂浓度较低的P型半导体硅衬底上,用半导体光刻、扩散工艺制作两个高掺杂浓度的N+区,并用金属铝引出两个电极,分别作为漏极D和源极S。然后在漏极和源极之间的P型半导体表面复盖一层很薄的二氧化硅(Si02)绝缘层膜,在再这个绝缘层膜上装上一个铝电极,作为栅极G。这就构成了一个N沟道(NPN型)增强型MOS管。显然它的栅极和其它电极间是绝缘的。图1-1所示 A 、B分别是它的结构图和代表符号。
同样用上述相同的方法在一块掺杂浓度较低的N型半导体硅衬底上,用半导体光刻、扩散工艺制作两个高掺杂浓度的P+区,及上述相同的栅极制作过程,就制成为一个P沟道(PNP型)增强型MOS管。下图所示分别是N沟道和P沟道MOS管道结构图和代表符号。
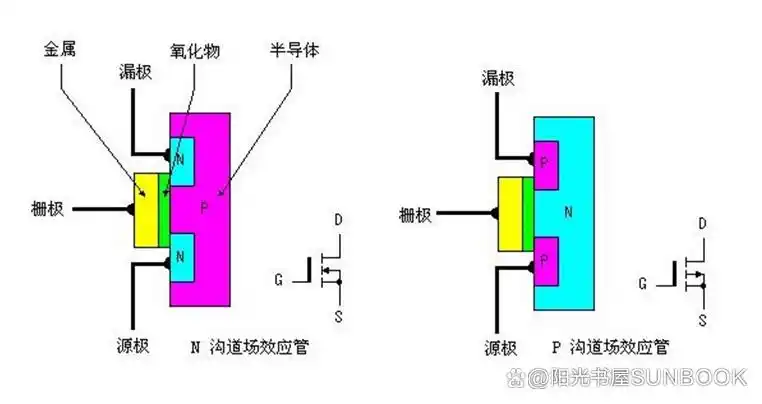
3.0 MOS管分类
按沟道分类,场效应管分为PMOS管(P沟道型)和NMOS(N沟道型)管。
按材料分类,可以分为分为耗尽型和增强型:
增强型管:栅极-源极电压 Vgs 为零时漏极电流也为零;耗尽型管:栅极-源极电压 Vgs 为零时漏极电流不为零。
其实归纳一下,就 4种类型的MOS管:
增强型 PMOS,增强型 NMOS,耗尽型 PMOS,耗尽型 NMOS。
在实际应用中,以 增强型NMOS 和 增强型PMOS 为主。所以通常提到NMOS和PMOS指的就是这两种。结合下图与上面的内容也能解释为什么实际应用以增强型为主,主要还是电压为0的时候,D极和S极能否导通的问题
下图列出了四种MOS管的比较:
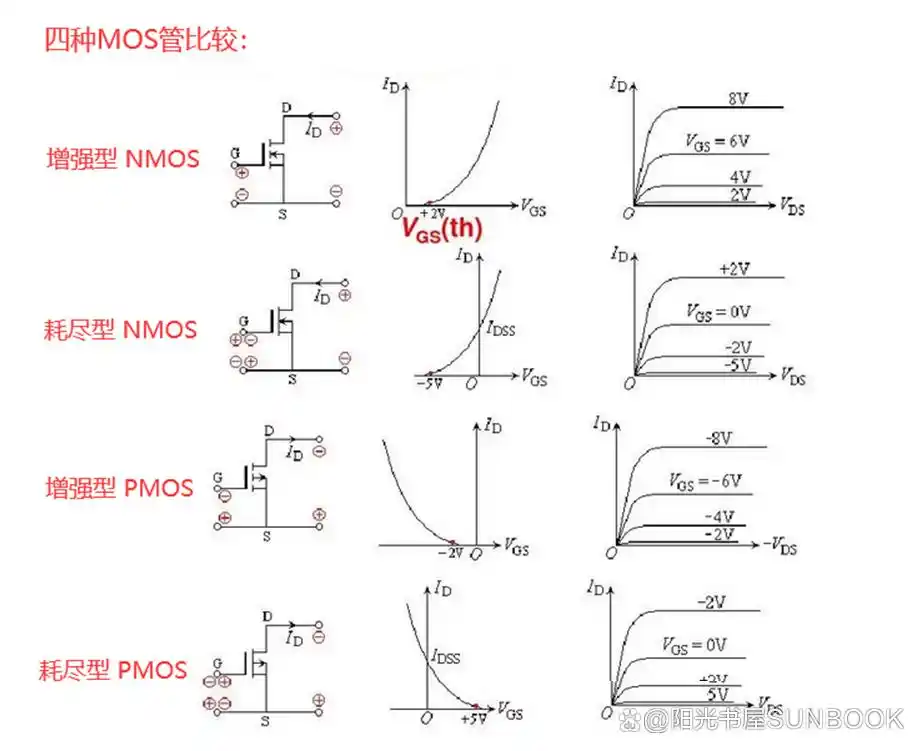
4.0 MOS管工作原理详解
(N沟道增强型为例)
当栅-源之间不加电压时即VGS=0时,源漏之间是两只背向的PN结。不管VDS极性如何,其中总有一个PN结反偏,所以不存在导电沟道。
当UDS=0且UGS>0时,由于SiO2的存在,栅极电流为零。但是栅极金属层将聚集正电荷.它们排斥P型衬底靠近 SiO2一侧的空穴,使之剩下不能移动的负离子区,形成耗尽层,如图6所示
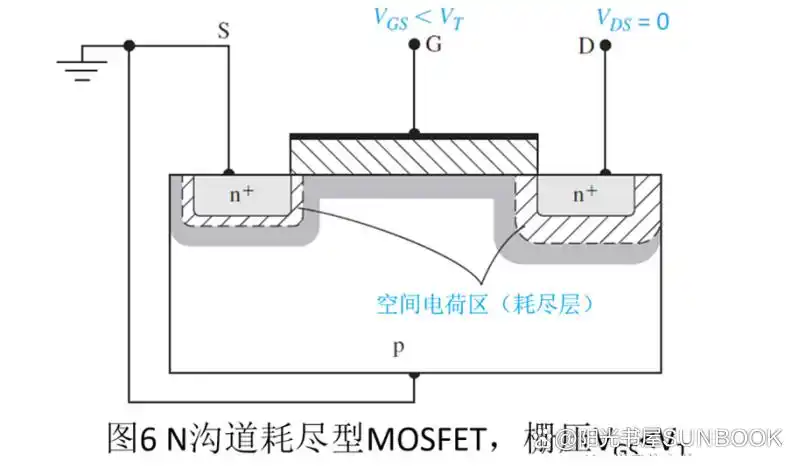
当UGS增大时,一方面耗尽层增宽,另一方面将衬底的自由电子吸引到耗尽层与绝缘层之间,形成一个N型薄层,称为反型层,如图7所示。这个反型层就构成了漏-源之间的导电沟道。使沟道刚刚形成的栅-源电压称为开启电压UGS(th)/VT。UGS电压越大,形成的反层型越厚,导电沟道电阻越小。
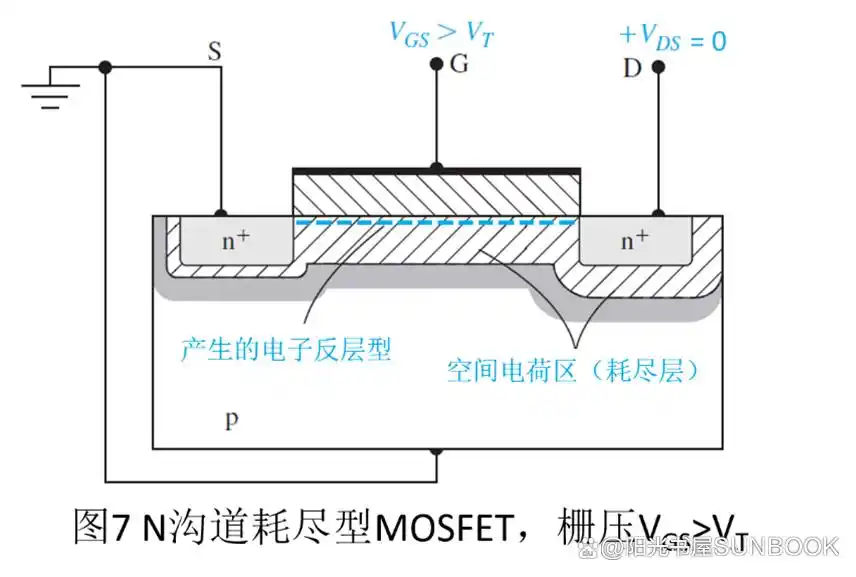
当VGS>VT且VDS较小时,基本MOS结构的示意图如图8-1所示。图中反型沟道层的厚度定性地表明了相对电荷密度,这时的相对电荷密度在沟道长度方向上为一常数。相应的ID-VDS特性曲线如图8-1所示。
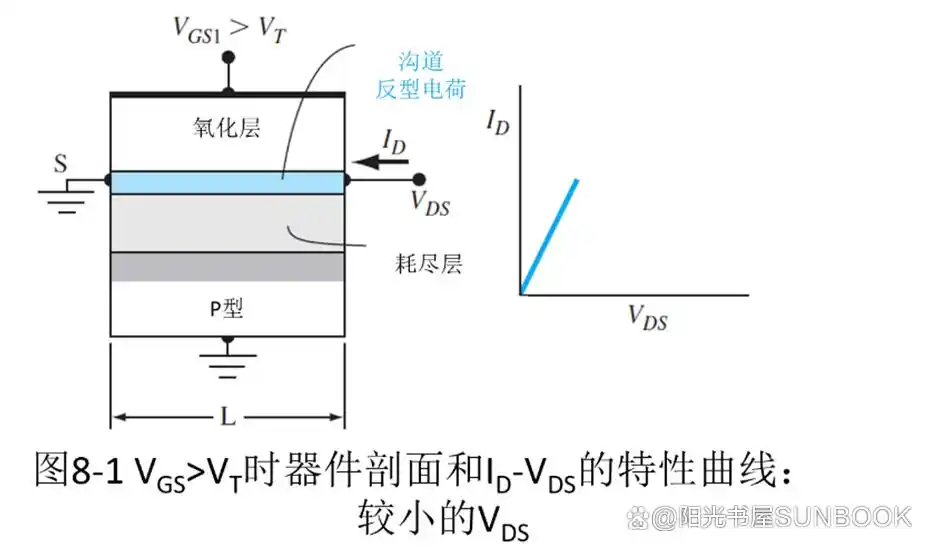
当VGS>VT且VDS增大时,由于漏电压增大,漏端附近的氧化层压降减小,这意味着漏端附近的反型层电荷密度也将减小。漏端的沟道电导减小,从而ID-VDS特性曲线的斜率减小,如图8-2所示。
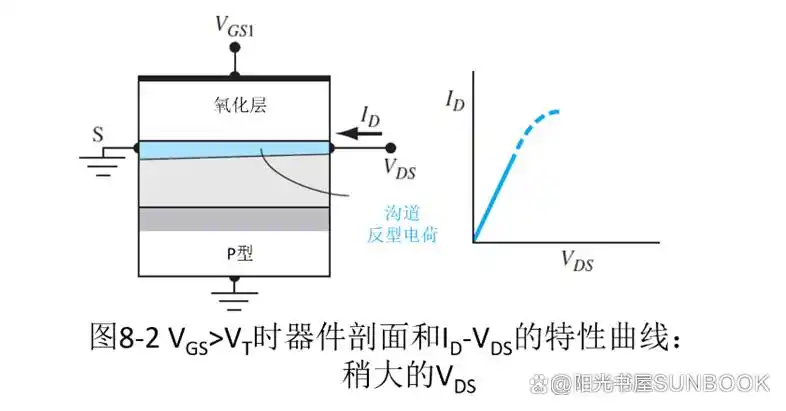
当VGS>VT且VDS增大到漏端的氧化层压降等于VT时,漏极处的反型层电荷密度为零,此时漏极处的电导为零,这意味着ID-VDS的特性曲线的斜率为零,称为预夹断,如图8-3所示。

当VGS>VT且VDS>VDS(sat)时,沟道中反型电荷为零的点移向源端。如果UDS继续增大,夹断区随之延长,如图所示,而且UDS的增大部分几乎全部用于克服夹断区对漏极电流的阻力,漏电流ID为一常数,这种情形在ID-VDS对应于饱和区(恒流区),如图8-4所示。
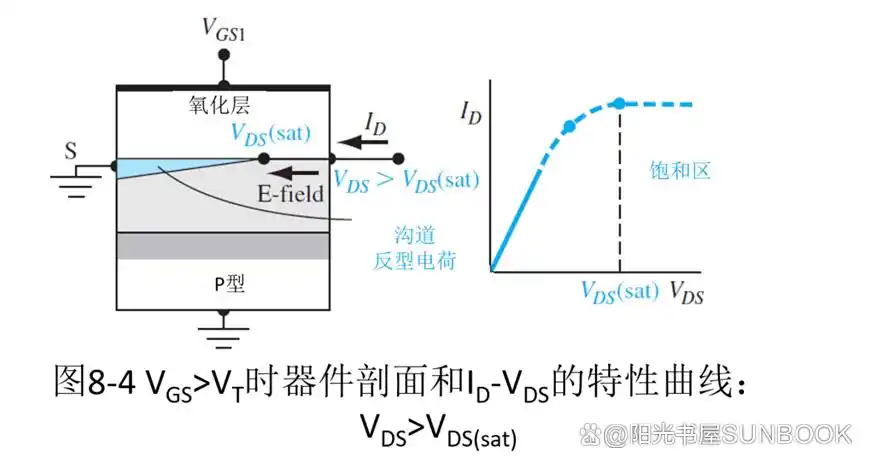
5.0 MOS管的工作参数
5.1、极限参数:
ID:最大漏源电流。是指场效应管正常工作时,漏源间所允许通过的最大电流。场效应管的工作电流不应超过 ID 。此参数会随结温度的上升而有所减额
IDM:最大脉冲漏源电流。此参数会随结温度的上升而有所减额
PD:最大耗散功率。是指场效应管性能不变坏时所允许的最大漏源耗散功率。使用时,场效应管实际功耗应小于 PDSM 并留有一定余量。此参数一般会随结温度的上升有所减额
VGS:最大栅源电压
Tj:最大工作结温。通常为 150 ℃ 或 175 ℃ ,器件设计的工作条件下须确应避免超过这个温度,并留有一定裕量
TSTG:存储温度范围
5.2、静态参数
V(BR)DSS:漏源击穿电压。是指栅源电压VGS 为 0 时,场效应管正常工作所能承受的最大漏源电压。这是一项极限参数,加在场效应管上的工作电压必须小于 V(BR)DSS 。它具有正温度特性。故应以此参数在低温条件下的值作为安全考虑。 V(BR)DSS/ Tj :漏源击穿电压的温度系数,一般为 0.1V/ ℃
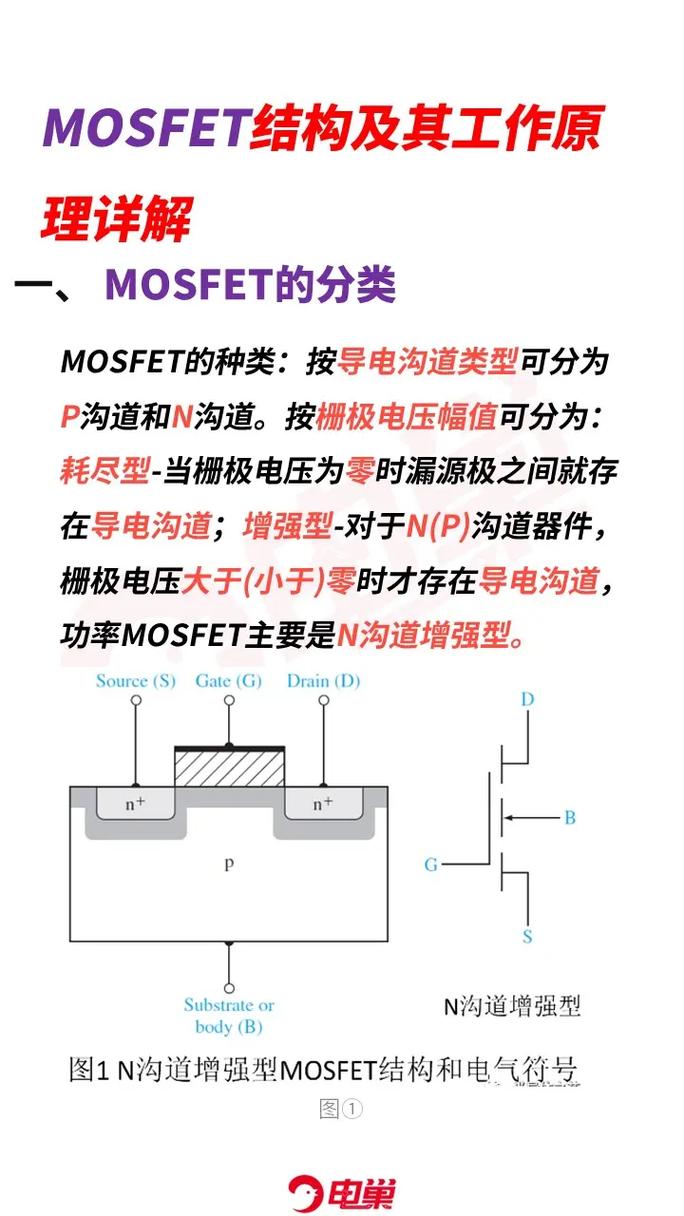
RDS(on):在特定的 VGS (一般为 10V)、结温及漏极电流的条件下, 导通时漏源间的最大阻抗。它是一个非常重要的参数,决定了 导通时的消耗功率。此参数一般会随结温度的上升而有所增大。故应以此参数在最高工作结温条件下的值作为损耗及压降计算
VGS(th):开启电压(阀值电压)。当外加栅极控制电压 VGS 超过 VGS(th) 时电子电路中MOS管讲解:定义、结构、分类及工作原理等,漏区和源区的表面反型层形成了连接的沟道。应用中,常将漏极短接条件下 ID 等于 1 毫安时的栅极电压称为开启电压。此参数一般会随结温度的上升而有所降低
IDSS:饱和漏源电流,栅极电压 VGS=0 、 VDS 为一定值时的漏源电流。一般在微安级
IGSS:栅源驱动电流或反向电流。由于输入阻抗很大,IGSS 一般在纳安级
5.3、动态参数
gfs :跨导。是指漏极输出电流的变化量与栅源电压变化量之比,是栅源电压对漏极电流控制能力大小的量度。gfs 与 VGS 的转移关系注意看图表
Qg :栅极总充电电量。 是电压型驱动器件,驱动的过程就是栅极电压的建立过程,这是通过对栅源及栅漏之间的电容充电来实现的,下面将有此方面的详细论述
Qgs :栅源充电电量
Qgd :栅漏充电(考虑到 效应)电量
Td(on) :导通延迟时间。从有输入电压上升到 10% 开始到 VDS 下降到其幅值 90% 的时间
Tr :上升时间,输出电压 VDS 从 90% 下降到其幅值 10% 的时间
Td(off) :关断延迟时间,输入电压下降到 90% 开始到 VDS 上升到其关断电压时 10% 的时间
Tf :下降时间,输出电压 VDS 从 10% 上升到其幅值 90% 的时间
Ciss :输入电容, Ciss= CGD + CGS ( CDS 短路)
Coss :输出电容,Coss = CDS +CGD
Crss :反向传输电容,Crss = CGD
MOS管的极间电容, 之感生电容被大多数制造厂商分成输入电容,输出电容以及反馈电容。所引述的值是在漏源电压为某固定值的情况下。此些电容随漏源电压的变化而变化,电容数值的作用是有限的。输入电容值只给出一个大概的驱动电路所需的充电说明,而栅极充电信息更为有用。它表明为达到一个特定的栅源电压栅极所必须充的电量。
5.4、雪崩击穿特性参数
这些参数是 在关断状态能承受过压能力的指标。如果电压超过漏源极限电压将导致器件处在雪崩状态
EAS:单次脉冲雪崩击穿能量。这是个极限参数,说明 所能承受的最大雪崩击穿能量
IAR:雪崩电流
EAR:重复雪崩击穿能量
5.5、体内二极管参数
IS:连续最大续流电流(从源极)
ISM:脉冲最大续流电流(从源极)
VSD:正向导通压降
Trr:反向恢复时间
Qrr:反向恢复充电电量
Ton:正向导通时间。(基本可以忽略不计)
6.0 MOS的基本特性
静态特性;
其转移特性和输出特性如图2所示。
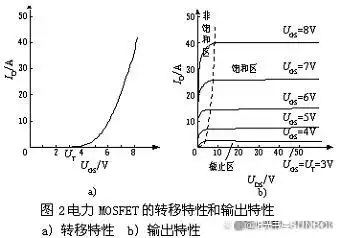
漏极电流ID和栅源间电压UGS的关系称为的转移特性,ID较大时,ID与UGS的关系近似线性,曲线的斜率定义为跨导Gfs 的漏极伏安特性(输出特性):截止区(对应于GTR的截止区);饱和区(对应于GTR的放大区);非饱和区(对应于GTR的饱和区)。电力 工作在开关状态,即在截止区和非饱和区之间来回转换。电力漏源极之间有寄生二极管,漏源极间加反向电压时器件导通。电力 的通态电阻具有正温度系数,对器件并联时的均流有利。
动态特性;
其测试电路和开关过程波形如图3所示。
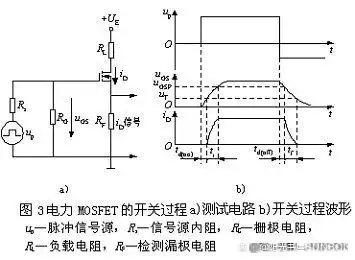
开通过程;
开通延迟时间td(on) —up前沿时刻到uGS=UT并开始出现iD的时刻间的时间段;
上升时间tr— uGS从uT上升到进入非饱和区的栅压UGSP的时间段;
iD稳态值由漏极电源电压UE和漏极负载电阻决定。UGSP的大小和iD的稳态值有关,UGS达到UGSP后,在up作用下继续升高直至达到稳态,但iD已不变。
开通时间ton—开通延迟时间与上升时间之和。
关断延迟时间td(off) —up下降到零起,Cin通过Rs和RG放电,uGS按指数曲线下降到UGSP时,iD开始减小为零的时间段。
下降时间tf— uGS从UGSP继续下降起,iD减小场效应管什么时候截止,到uGS
关断时间toff—关断延迟时间和下降时间之和。
的开关速度。
的开关速度和Cin充放电有很大关系,使用者无法降低Cin, 但可降低驱动电路内阻Rs减小时间常数,加快开关速度,只靠多子导电,不存在少子储存效应,因而关断过程非常迅速,开关时间在10— 100ns之间,工作频率可达以上,是主要电力电子器件中最高的。 场控器件静态时几乎不需输入电流。但在开关过程中需对输入电容充放电,仍需一定的驱动功率。开关频率越高,所需要的驱动功率越大。 2.4动态性能的改进在器件应用时除了要考虑器件的电压、电流、频率外,还必须掌握在应用中如何保护器件,不使器件在瞬态变化中受损害。当然晶闸管是两个双极型晶体管的组 合,又加上因大面积带来的大电容,所以其dv/dt能力是较为脆弱的。对di/dt来说,它还存在一个导通区的扩展问题,所以也带来相当严格的限制。 功率的情况有很大的不同。它的dv/dt及di/dt的能力常以每纳秒(而不是每微秒)的能力来估量。但尽管如此,它也存在动态性能的限制。这些我们可以从功率的基本结构来予以理解。 图4是功率的结构和其相应的等效电路。除了器件的几乎每一部分存在电容以外,还必须考虑还并联着一个二极管。同时从某个角度 看、它还存在一个寄生晶体管。(就像IGBT也寄生着一个晶闸管一样)。这几个方面,是研究动态特性很重要的因素。
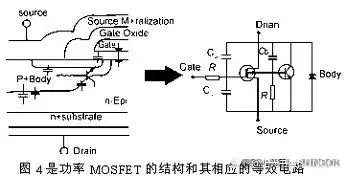
首先结构中所附带的本征二极管具有一定的雪崩能力。通常用单次雪崩能力和重复雪崩能力来表达。当反向di/dt很大时,二极管会承受一个速 度非常快的脉冲尖刺,它有可能进入雪崩区,一旦超越其雪崩能力就有可能将器件损坏。作为任一种PN结二极管来说,仔细研究其动态特性是相当复杂的。它们和 我们一般理解PN结正向时导通反向时阻断的简单概念很不相同。当电流迅速下降时,二极管有一阶段失去反向阻断能力,即所谓反向恢复时间。PN结要求迅速导 通时,也会有一段时间并不显示很低的电阻。在功率中一旦二极管有正向注入,所注入的少数载流子也会增加作为多子器件的的复杂性。 功率的设计过程中采取措施使其中的寄生晶体管尽量不起作用。在不同代功率中其 措施各有不同,但总的原则是使漏极下的横向电阻RB尽量小。因为只有在漏极N区下的横向电阻流过足够电流为这个N区建立正偏的条件时,寄生的双极性晶闸管 才开始发难。然而在严峻的动态条件下,因dv/dt通过相应电容引起的横向电流有可能足够大。此时这个寄生的双极性晶体管就会起动,有可能给 带来损坏。所以考虑瞬态性能时对功率器件内部的各个电容(它是dv/dt的通道)都必须予以注意。



